工智能计算需求不断攀升,传统半导体封装和散热方式面临极限。
ECTC 2025 展示了三维器件堆栈所依赖的新一代技术路径,包括直接液体冷却、亚微米级混合键合、玻璃载体RDL、背面供电网络和共封装光学等关键创新,提升了热管理和系统性能,对未来高性能计算芯片的架构和装配逻辑改变是比较大的。
艾邦建有服务器液冷散热交流群,聚焦服务器液冷技术前沿,涵盖冷板/浸没/喷淋式方案设计、材料升级(耐腐蚀管路、密封件创新)、CDU运维与能效优化、政策标准解读(PUE、OCP规范)等。欢迎大家加入我们,共绘服务器液冷散热未来!


直接液体冷却与芯片结构的热演化
为了应对高功耗AI芯片带来的热挑战,封装级液体冷却成为当前发展的重点。传统的风冷系统在1,000瓦级功耗下,风扇与输电线路功耗占比已达40%。
-
台积电展示了集成微冷却器(IMEC-Si)方案,内嵌于CoWoS封装平台中,采用铜柱阵列与有机中介层实现芯片背面水冷,支持高达3,000瓦的封装功耗,功率密度可达2.5 W/mm²。
组装过程通过C4凸块翻转贴装,并在SoC外围点涂弹性密封剂,有效控制芯片翘曲并实现散热歧管的精准安装。
该结构通过氦气泄漏与早期可靠性测试,验证其高性能散热能力。
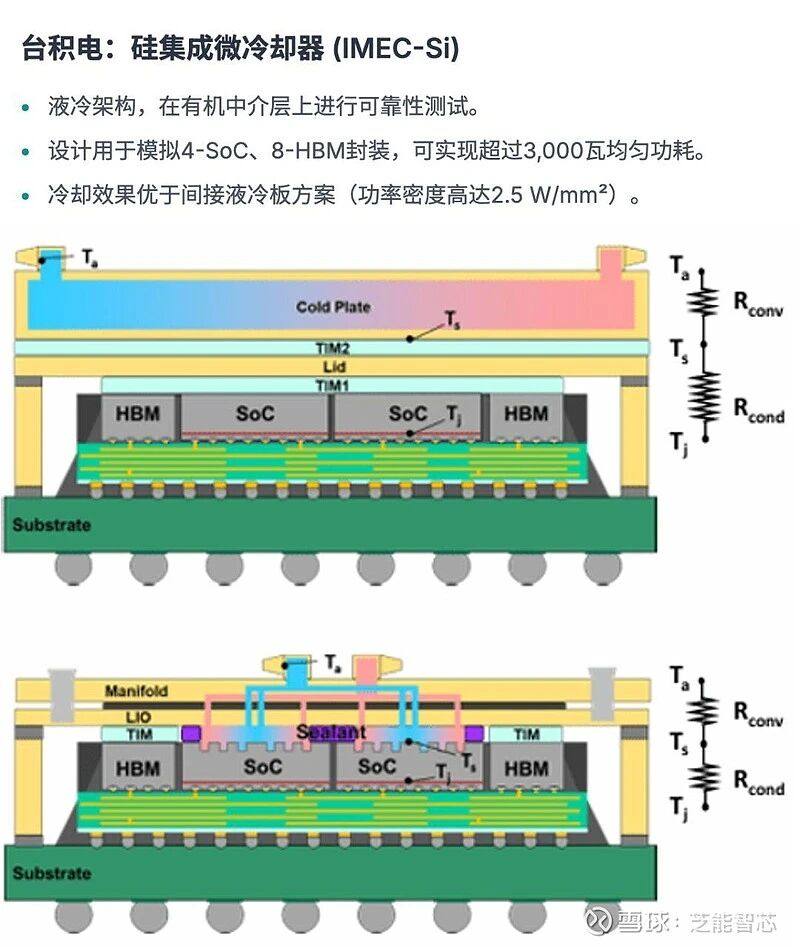
-
佐治亚理工提出——将芯片本身转化为冷却结构,采用5nm硅工艺制备微鳍片散热器,结合TSV通孔,构建硅柱液冷路径,冷却能力达300W/cm²。
通过TSV+硅微结构的三维液体通道,热量能从核心逻辑层高效排出。这种方式为未来标准化冷却芯片构建提供了模型基础,尤其适用于开放芯粒生态中不同冷却能力的模块组合。

-
三星探索了非对称铜基散热块的堆叠结构,将铜块置于2nm环绕栅极晶体管逻辑芯片正上方,配合背面供电网络,提升20%以上的热释放效率。
其通过有限元热模拟(ANSYS)识别应力集中区,调整RDL图案长度与成型材料,降低热应力导致的裂纹风险。散热已不再是系统后处理问题,而是设计早期需要综合考量的基础物理约束。
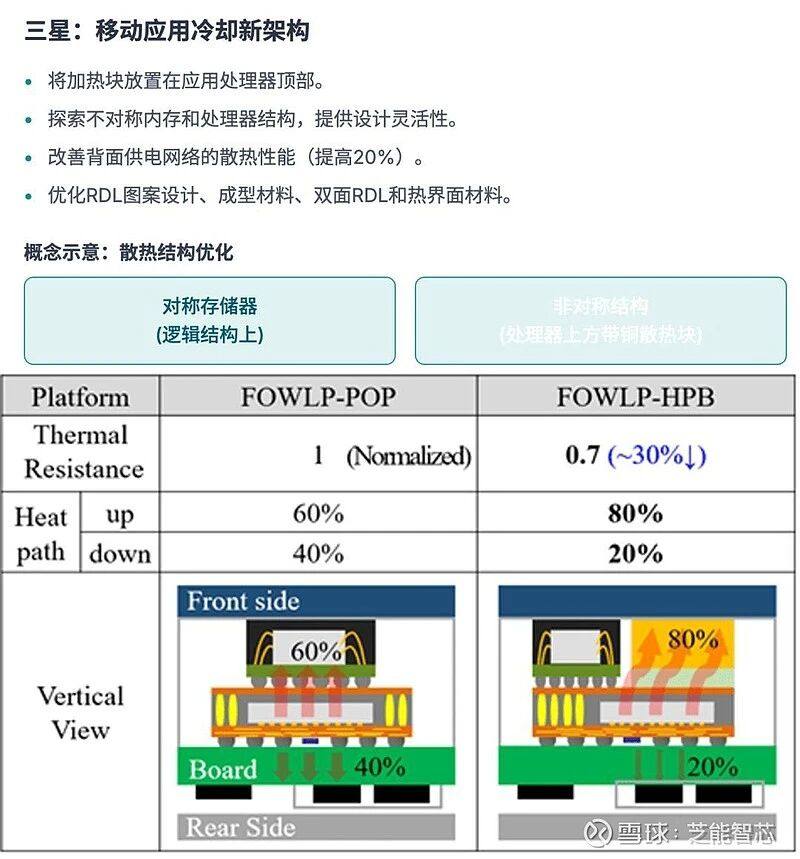
混合键合、背面供电与光学集成的封装变革
混合键合技术正在快速突破1µm间距限制。
-
工研院与Brewer Science提出的聚合物/铜混合键合RDL,采用负性光刻胶、Ti阻挡层、Cu填充与CMP抛光工艺,在玻璃载体上实现10层堆叠,结构可靠性优于传统中介层方案,且能实现更低损耗的高速I/O互联。热压键合温度为300°C,翘曲控制良好,适配多层封装结构。
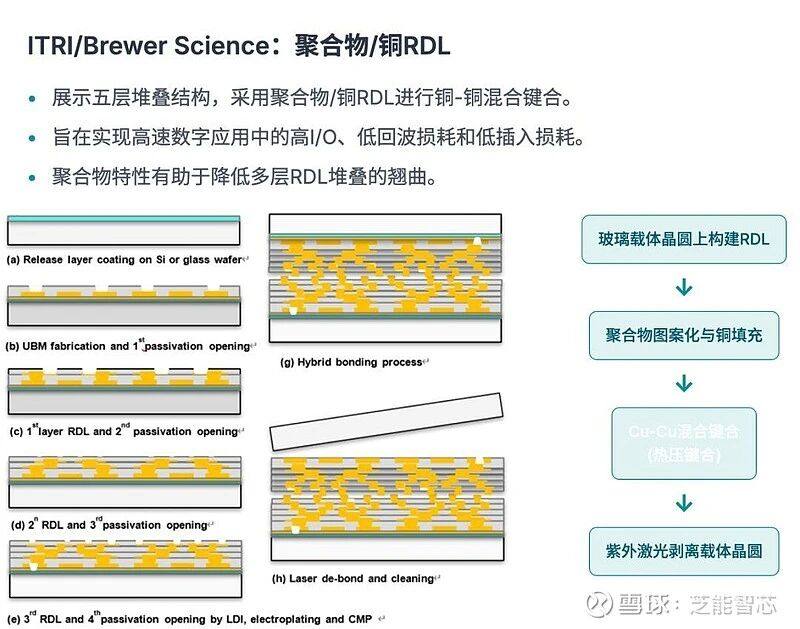
-
英特尔则将键合精度控制深入至芯片内部,从传统的边角错位控制进化为片内精度测量。
对于D2W工艺而言,实现1µm以下的混合键合需要整个芯片表面达到纳米级对准误差,这促使对键合设备、标记策略及红外脱键等工艺进行系统优化,以便重复利用硅载体并控制总成本。
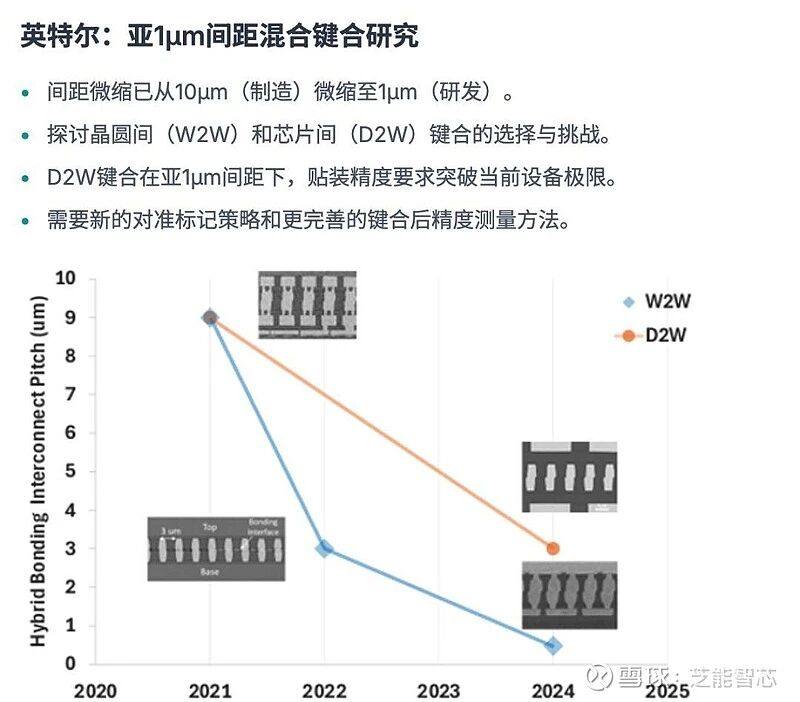
背面供电网络(BSPDN)成为芯片热流结构的重要变量,通过在晶圆背部构建电源网,仅正面用于信号传输,降低IR drop,提升频率和能效,这种架构也在堆栈中引入了新的热挑战。
基于材料异质性的AI热建模方案,结合GDS与局部功耗信息,建立精细的热阻预测系统,并用于设计阶段的优化,逻辑芯片位于顶部有利于冷却,而存储器置顶则限制了逻辑芯片的功耗释放能力,堆栈顺序与冷却结构的协同设计已成为3D集成的关键要素。

共封装光学(CPO)技术同样得到重视。ASE展示了可将光引擎与GPU、HBM共封装的光电平台,支持每根光纤6.4Tb/s带宽。
通过将光接口贴近计算核心,不仅大幅降低IO延迟与功耗,也提升了数据中心光链路的集成密度与可维护性。
康宁与Fraunhofer开发的二维平面玻璃波导方案,为CPO提供了一种新型低成本、高密度光互联结构。
其利用热离子交换将单模波导嵌入熔融玻璃面板中,实现面板级1024路光连接,适配于102.4Tb/s光交换芯片架构。
小结
人工智能计算正推动半导体产业进入前所未有的高热密度与高带宽时代。从液体冷却、混合键合到背面供电与光学集成,封装已成为决定性能瓶颈与系统能效的关键环节,理解热-结构-电信号耦合效应,并将其引入设计阶段,正在成为构建下一代3D AI芯片系统的基本能力。
来源:雪球 芝能智芯
艾邦建有服务器液冷散热交流群,聚焦服务器液冷技术前沿,涵盖冷板/浸没/喷淋式方案设计、材料升级(耐腐蚀管路、密封件创新)、CDU运维与能效优化、政策标准解读(PUE、OCP规范)等。欢迎大家加入我们,共绘服务器液冷散热未来!

资料来源:https://xueqiu.com/5987722932/341490762?md5__1038=287ec7c416-w1PuquOuPWxWeOv3amWMW%3DMfhWE26PqeB3jmqPpr_xpq930wWAWcB0pWUCM0URI6uSMWw9hW2up2Wxu3FWouJ0WzuCVWbuCHW_unhidhWS0SbuW433WnvWrlXAXWQWSq_1IqRv3mWI1lMWR9WS7WWg3eFTn1CsMB0qJWWpWeRoJeRfW61MbHWjf316W
微信扫描下方的二维码阅读本文
- 热交换核心 :冷板(CPU/GPU专用)、CDU(冷量分配单元);
- 循环网络 :Manifold分液器、EPDM/PTFE管路、快接头;
- 动力与控制 :变频循环泵(如飞龙股份电子泵)、智能温控系统。


